沈阳宇杰真空设备有限公司
电话:13555776988
网址:www.syyjzk.com
淘宝店铺:https://shop311771663.taobao.com
地址:辽宁省沈阳市沈河区泉园街道
离子束溅射镀膜技术之所以能实现高度均匀的涂层,核心原因在于其独特的“分离式”设计理念和高度可控的物理过程。与传统的磁控溅射等直接在高真空腔体内产生等离子体的技术不同,IBS将离子产生、靶材溅射、基片沉积三个关键过程在物理空间上分离开,并分别进行控制。这种设计带来了多方面的优势,共同确保了涂层的均匀性。
以下是其实现均匀涂层的几个关键因素:
1. 高度准直与方向性强的离子束
这是IBS技术核心的优势。离子源(如考夫曼源)通过栅极系统将氩气等离子体萃取并加速,形成一束能量、方向和流量都高度可控的离子束。这束离子流就像一把“原子刻刀”,以固定的角度轰击靶材。
方向稳定性:离子束的飞行方向非常稳定,几乎不会发生随机散射。这意味着溅射出的靶材原子具有一个明确的方向(遵循余弦定律),而不是向四面八方杂乱无章地飞溅。
消除“跑道效应”:与传统磁控溅射中电子在环形磁场约束下做螺旋运动,导致靶材被溅射出不均匀的“跑道”状刻蚀区不同,IBS的离子束可以均匀地扫描整个靶面,确保靶材被均匀刻蚀,从而从源头上保证了长时间镀膜时溅射粒子流强度的稳定性。
2. 束流扫描与控制
为了进一步优化均匀性,先进的IBS系统配备有束流扫描系统。通过电磁场控制,可以使离子束在靶材表面进行特定图案(如线性或圆形)的扫描。
均匀刻蚀靶材:扫描功能避免了离子束长时间轰击靶材的同一位置,既防止了靶材被局部击穿,又确保了整个靶面被均匀地利用。一个被均匀刻蚀的靶材是产生稳定且空间分布一致的原子流的先决条件。
可调节的沉积分布:通过编程改变扫描方式和速度,可以在一定程度上“塑造”从靶材溅射出的原子云的角分布,从而主动补偿沉积均匀性,使其适应不同形状和位置的基片。
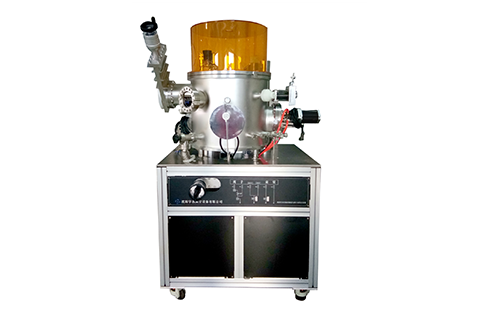
3. 独立控制的基片台
在IBS系统中,承载基片的样品台通常是可旋转和公转的。这个设计至关重要:
消除点源效应:即使溅射原子流在空间分布上存在微小的不均匀性(例如,中心浓边缘稀),通过不断旋转基片,基片上的每一点都会交替暴露在原子流“浓”和“稀”的区域。在时间上进行平均后,整片基片上所接收到的原子总量就变得均匀。
保证复杂曲面覆盖:对于曲面基片或大批量基片,多轴旋转可以确保原子蒸气能够无死角地包裹基片,实现共形沉积,大大提升了三维器件的镀膜均匀性。
4. 低温与高能过程
低热负荷:由于离子源与沉积室分离,基片不会暴露在高密度的等离子体中,因此受到的电子轰击和辐射加热效应很弱,基片温度可以保持较低。这避免了因热应力或高温下原子迁移率不同导致的膜层结构不均匀问题。
高能沉积粒子:IBS溅射出的原子具有较高的动能(通常为10-50 eV,远高于热蒸发技术的~0.1 eV)。这些高能原子在沉积到基片表面后,仍有足够的能量进行短程迁移,找到更稳定的晶格位置。这有助于形成致密、光滑、缺陷少的膜层,提升了膜层在微观结构上的“均匀性”。
5. 优越的工艺稳定性
分离式设计避免交叉污染:离子产生过程(在离子源中)与沉积过程(在沉积室中)分离,两者互不干扰。这避免了传统溅射中靶材污染物被活化电离后沉积到基片上的问题。
控制工艺参数:离子束的能量、电流、氩气流量、真空度等所有关键参数都可以独立监控和反馈控制,确保整个数小时甚至数十小时的镀膜过程中,工艺条件稳定,无波动。稳定性是重现性的基础,而重现性则是大面积均匀性的保证。
综上所述,离子束溅射系统并非通过单一技术,而是通过一套组合拳来实现均匀性:一个方向性很强且可扫描的离子束确保了溅射源的高度可控;一个独立旋转的基片台从空间和时间上平均了原子流分布;低温高能的沉积环境保障了膜层微观结构的致密与均匀;而整个系统的分离式设计和控制则为上述所有过程提供了稳定的基础。
文章内容来源于网络,如有问题请和我联系删除!